MOCVD用in-situひずみ・応力・温度・反射率・膜厚測定システム kSA ICE
メーカー名:k-Space Associates, Inc.


製品情報
概要
GaN(LED、パワーデバイス)のMOCVD成膜中のin-situ測定に特化した製品です。
必要機能に応じて以下から選択でき、後にアップグレードすることも可能です。
| kSA ICE | 反射率・黒体輻射温度・ひずみ・応力 |
| kSA ICE-R | 反射率 |
| kSA ICE-RB | 反射率・黒体輻射温度 |
| kSA ICE-RC | 反射率・ひずみ・応力 |
| kSA Blue ICE | 反射率・黒体輻射温度・ひずみ・応力・GaN薄膜表面温度・膜厚・粗度 |
STANDARD HARDWARE LAYOUT
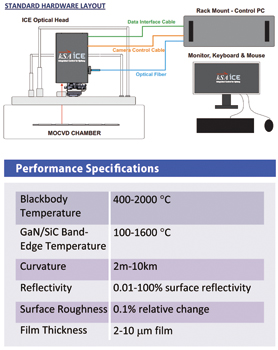
マルチウェハ測定
・マルチウェハ測定機能は標準ですが、シングルウェハ測定のみへのダウングレードも可能です。
・Excelや画像ファイル(tiff、bmp等)の出力も簡単に行えます。

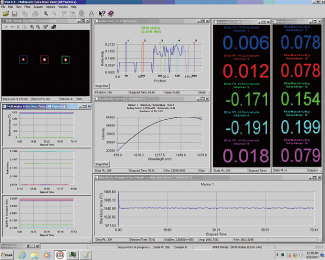
kSA mini-MOS
概要
エタロンによる平行配列マルチレーザービーム(特許)によるサンプル照射、CCDカメラによるビーム位置の検出、
取得画像のビームスポット間距離変化を見て、薄膜にかかる歪み、応力を測定します。
CVD、MOCVD、スパッタ装置、MBE装置の基板に対応しています。研究・開発のみならず、製造プロセスにおいても薄膜作成過程のリアルタイムモニタシステムとして使用できます。
特長
- 2つのエタロンによる高解像度2Dマルチビーム光学系センサークノロジー(特許)によりx、y方向のひずみを測定
- 反射レーザー強度振動による薄膜厚・成長率・光学定数の精密測定が可能
- レーザースポットの同時検出により、基板回転などの振動の影響はほとんど受けずに測定
- 曲率半径4~10km(装置の仕様に依る)までのひずみ測定が可能
- フレキシブルなカスタムマウントデザインを提供
- 外部トリガ機能により回転基板にも対応
アプリケーション
- .低温GaNバッファレイヤー上の高温GaN膜成長時の応力・膜厚をモニター可能(基板回転スピード1200rpmにも対応)反射レーザー強度振動は正確な膜厚測定を提供
- MOSの反射レーザー強度振動は、例えば厚いDLC薄膜の層成長モニターに応用可能振動は正確な光学定数、個々のレイヤー薄膜膜厚を算出
構成
- 高感度8bit CCD
- 集積レーザー光学系
- サーボ制御光学ミラー
- Dell デスクトップPC 又は ラックマウントコンピュータ
- 制御ボード(Scientific Grade Frame Digitization Board, Multifunction Digital and Analog I/O board, Servo Control Board)
Veeco D180 (GaN MOCVD system) に
マウントされたkSA mini-MOS
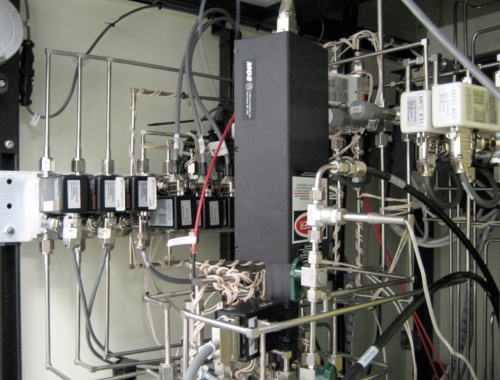
mini-MOS 測定仕組み
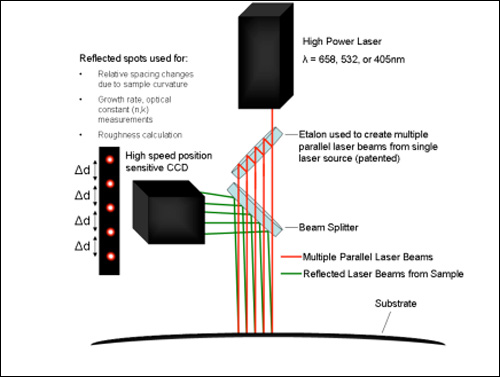
mini MOSひずみ測定例
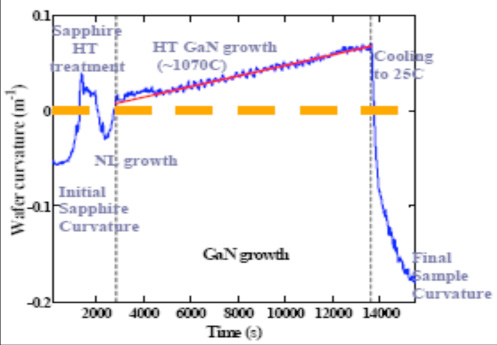
mini MOSひずみ&反射率測定例
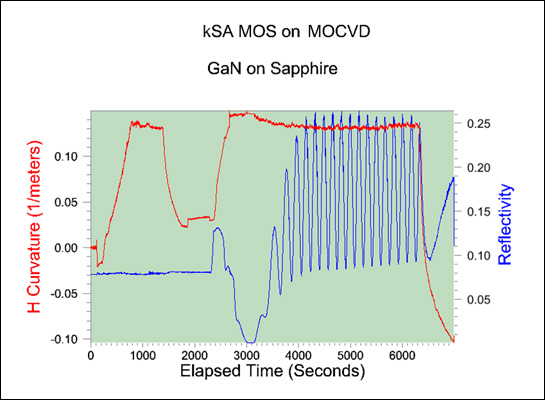
mini MOS応力測定例

In-situ ひずみ・応力測定システム 機能比較表
| 優れている | 普通 | 劣っている |
| 2D平行配列ビームスポット (kSA MOS, since 2001) | 2スポット (L社) | 1スポット (ディフレクトメータ) | |
| 分解能、 再現性、 感度 | 2D平行配列ビームスポット(特許)の全スポット間測定により、従来製品の10倍以上の測定再現性&分解能を実現 | 高分解能を得るには2スポットを大きな距離を開けて配置する必要がある。 一定のひずみ測定のみ可能、高分解能システムには追加光学系が必要となり、レーザースポット間のシグナル検知に影響を及ぼす可能性がある。 | 光学系とディテクタが統合されていないため、粗いひずみ測定しかできない |
| 精度 | 校正用にフラットミラー及び曲率半径の分かっているサンプルが付属 | 校正方法不明 | 校正方法不明 |
| 対”振動” | 複数(最小4個)のスポットを使いその平均値を測定できるため、振動に非常に有効・ビームは1つの光学系からエタロン(特許)を通して分割、2次元配列平行ビームの平行も保証 | 2スポットのみ使用:高分解能システムには追加光学系が必要となり、レーザースポット間のシグナル検知に影響を及ぼす可能性がある | 光学系とディテクタが統合されていないため、粗いひずみ測定しかできない |
測定値のぶれ | 光学系とレーザーモジュールは強固に固定され、温度も一定に保持 | 高分解能システムには追加光学系が必要となり、レーザースポット間のシグナル検知に影響を及ぼす可能性がある | 光学系とディテクタが統合されていないため、粗いひずみ測定しかできない |
| 2D空間分解能、x, y | 2D配列平行ビームスポット(特許)によるx方向&y方向のリアルタイムひずみ・応力測定が可能。 | 機能なし (1Dのみ) | なし |
| 大きいひずみ変化 又はW, D, 300mm以上に おけるサンプル振動 | オートミラー制御(特許)により、ビームスポットお捉え続ける(自動追尾) | スポットがディテクタの検知範囲から外れやすい。 より大きいレンズに交換した場合:光路がずれてしまい測定誤差を生む | スポットがディテクタの検知範囲から外れやすい。 より大きいレンズに交換した場合:光路がずれてしまい測定誤差を生む |
| サンプル表面の反射率変化 | クローズドループレーザー輝度制御機能(特許)により、表面反射率の変化中のシグナル・ノイズ比は最大で保持される | 表面の反射率の変化でシグナル・ノイズ比(S/N比)が変化してしまう | 表面の反射率の変化でシグナル・ノイズ比(S/N比)が変化してしまう |

