ex-situ ウェハキャリア検査システム kSA Emissometer
メーカー名:k-Space Associates, Inc.

製品情報
概要
反射率/放射率マッピング測定、及びウェハポケット深さの測定によりMOCVDウェハキャリアの残留薄膜やSiCコーティングのクラック・破片を検出できます。残留薄膜やクラックは膜中への不純物や温度ムラの原因となりウェハの品質・歩留まりに影響を及ぼしますので、ウェハキャリア交換時期を明確に判断できることで生産効率が向上します。
アプリケーション
- MOCVD装置のウェハキャリアの交換時期の明確な判断
- ウェハ温度均一性へ影響の可能性があるウェハポケットのザグリ具合の均一性チェック
- オプションのUV-PL(UVフォトルミネッセンス)測定により
ウェハやウェハキャリア上のダストや他の異物の検出
![]() ▶︎散乱反射マッピングでウェハポケット端の不良を検知。散乱反射を見ることで放射率を算出
▶︎散乱反射マッピングでウェハポケット端の不良を検知。散乱反射を見ることで放射率を算出
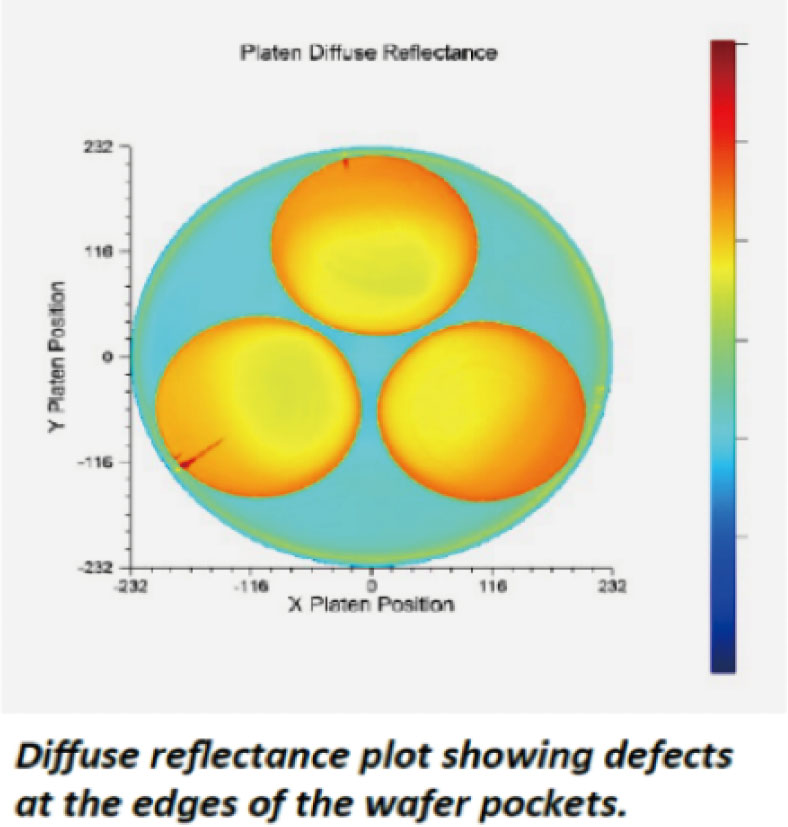
▶︎![]() 直反射マッピングでウェハポケットのザグリ具合の均一性の確認
直反射マッピングでウェハポケットのザグリ具合の均一性の確認
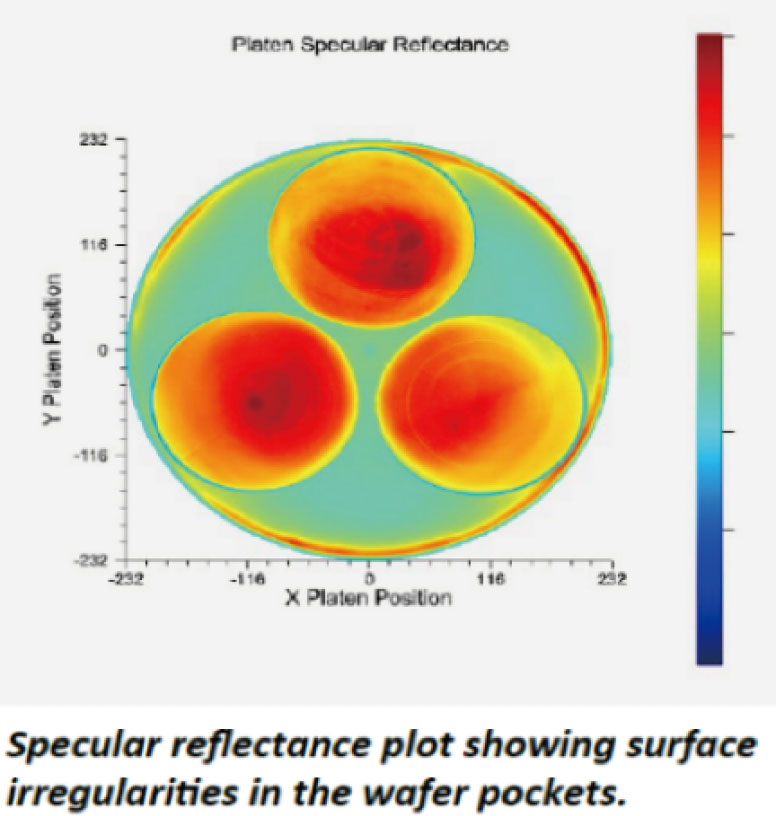
▶︎![]() UVフォトルミネセンスマッピングにより AlNウェハ上のダストを検知
UVフォトルミネセンスマッピングにより AlNウェハ上のダストを検知
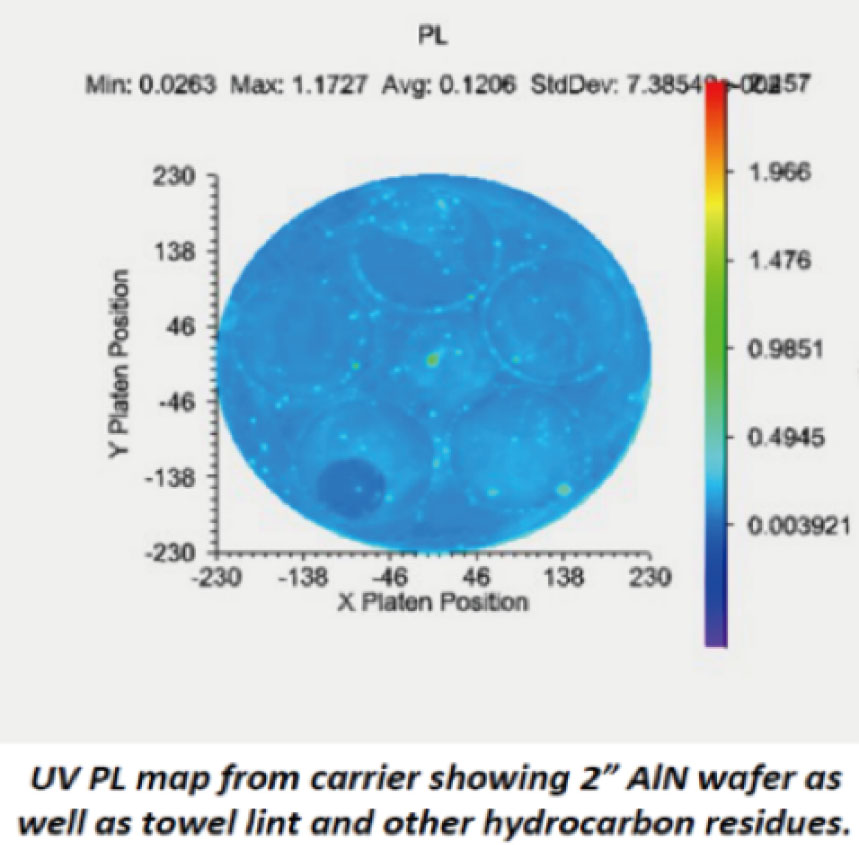
【仕様】
| 対応サイズ | 〜800㎜ |
| 対応ウェハキャリア | ほぼ全ての市販品に対応 |
| スキャン分解能 | 0.2㎜ radial, 0.1° azimuth |
| スキャン時間 | 10分 |
| (0.1° 1 ㎜ resolution, 465 ㎜) |
【反射率/放射率】
| 検知スポット径 | 1.5 ㎜ |
| 光源波長 | 940 nm |
| 反射分解能 | ±0.005 |
| 反射精度 | ±0.01 |
| 放射分解能 | ±0.01 |
| 放射精度 | ±0.02 |
【ポケット深さ】
| 検知スポット径 | 0.2 ㎜ |
| 光源波長 | 660 nm |
| 深さ分解能 | ±10 μm |
| 深さ精度 | ±10 μm |
▶︎通常、ウェハキャリアは次のプロセスでの再使用前に高温加熱炉によりウェハキャリア上の蒸着膜を除去します(アニール処理)。蒸着膜が残留している場合、ウェハの品質に影響を及ぼす可能性があるためです。蒸着膜の残留は放射率マッピング測定により確認できます。

▶︎ウェハキャリアにクラックが発生した状態で使用すると、SiCコーティング下のカーボンが成膜の品質に影響を及ぼすだけでなく、ウェハキャリア自体が成膜プロセス中又はアニール処理中に粉々に破損しかねません。クラック有無は放射率マッピングにより確認できます。
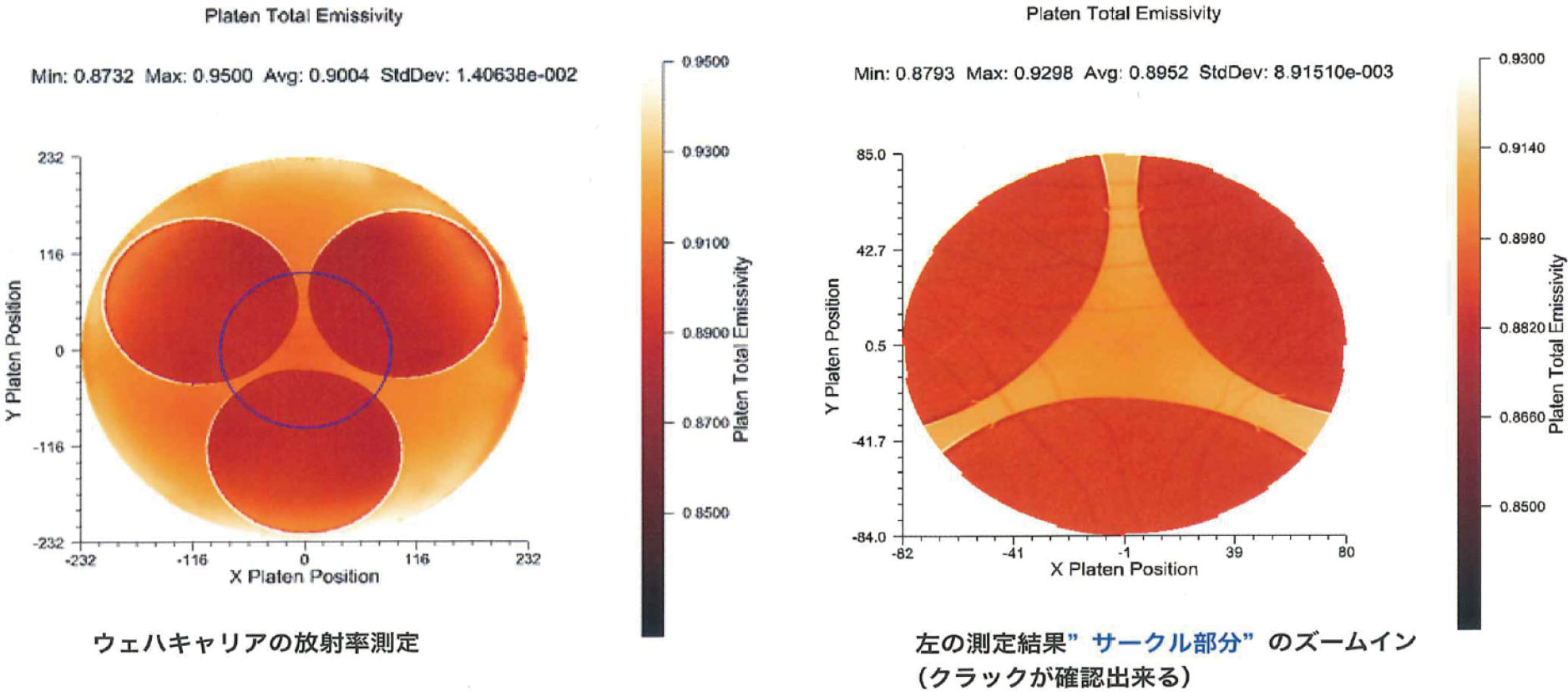
▶︎ウェハキャリア入荷時の品質検査として、2Dマッピング及びラインプロファイルによりウェハポケット高さ(深さ)解析が行えます。ポケットのザグリ具合が均一でない場合、サプライヤに良品への交換要求をお薦めします。
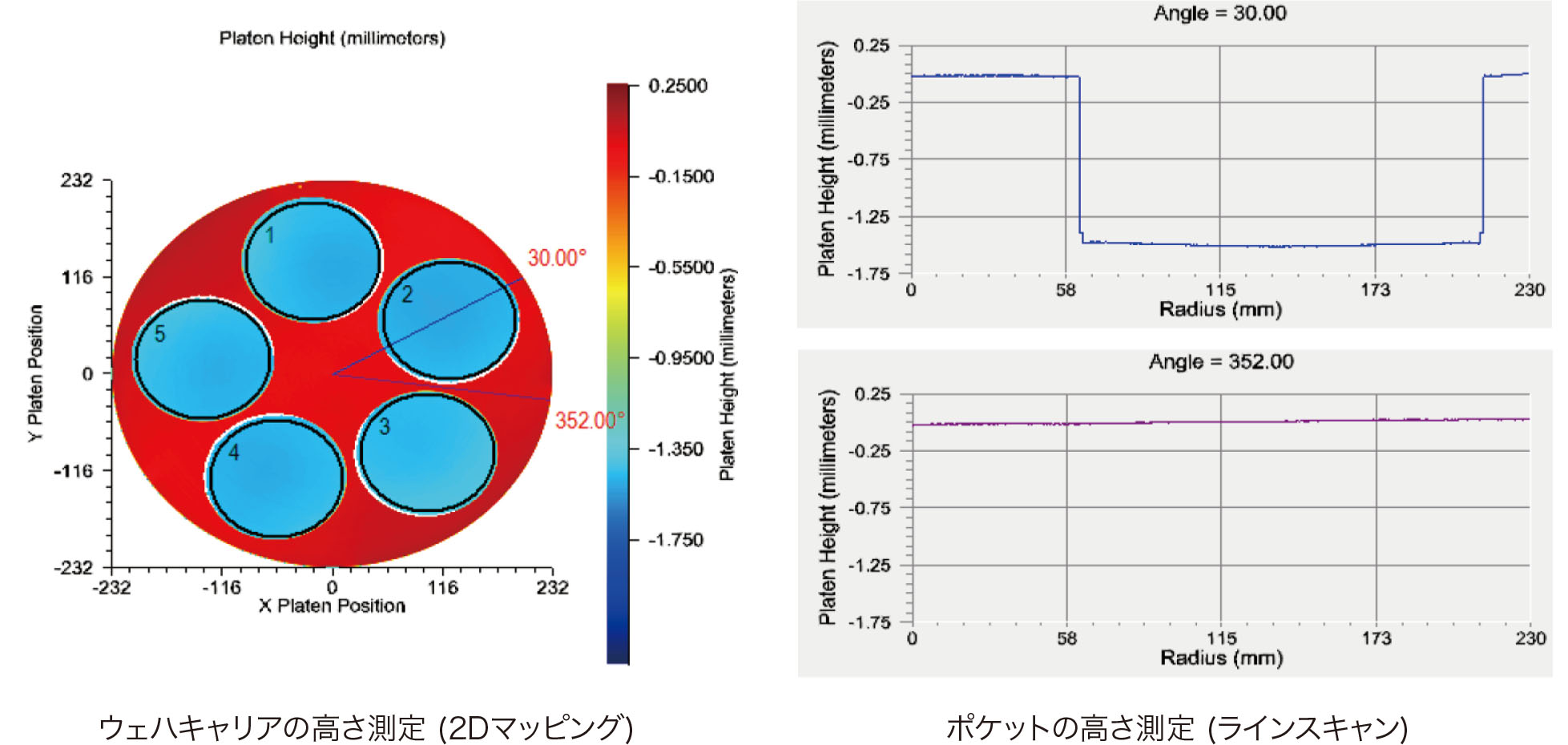
▶︎ポケット解析のレポート作成が容易に出来ます。